湿法边缘蚀刻和清洗工艺可提高晶圆产能
2022-11-2 0:00:00
在本博客系列中,我们将研究主要的晶圆清洗工艺,以及如何利用我们的解决方案应对相关问题。我们将在本篇文章中探讨边缘蚀刻:何为边缘蚀刻?边缘蚀刻面临哪些挑战?相较于传统的干法边缘蚀刻,我们在应对这些挑战上有何明显优势?
边缘蚀刻工艺可用于去除晶圆边缘任何类型的薄膜材料,如电介质、金属、有机物、氮化硅以及氧化硅薄膜材料。在边缘蚀刻过程中,晶圆被夹在顶板和底板之间, 因此晶圆边缘是其唯一外露的部分。下图1中的简化图显示,晶圆边缘并非完全平坦,其上方和下方实际上略圆。聚积的颗粒物和晶圆边缘的剥落物会造成污染,从而导致产能受损。边缘蚀刻和清洗工艺可以有效杜绝这些问题。
边缘蚀刻工艺可用于去除晶圆边缘任何类型的薄膜材料,如电介质、金属、有机物、氮化硅以及氧化硅薄膜材料。在边缘蚀刻过程中,晶圆被夹在顶板和底板之间, 因此晶圆边缘是其唯一外露的部分。下图1中的简化图显示,晶圆边缘并非完全平坦,其上方和下方实际上略圆。聚积的颗粒物和晶圆边缘的剥落物会造成污染,从而导致产能受损。边缘蚀刻和清洗工艺可以有效杜绝这些问题。
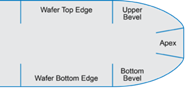
图一
图1从晶圆平面到斜面及边缘的过渡部分会形成一个薄膜容易分层或剥落的高应力区。
3D NAND闪存市场预计将大幅增长。美国联合市场研究机构(Allied Market Research)的数据显示,到2030年,全球3D NAND闪存市场预计将达到782亿美元,这意味着2021年至2030年间的年复合增长率将达20.3%。这一增长的关键驱动因素包括:3D NAND设备的性能提升且延迟降低,以及各类数据中心(闪存器件的主要消费群体)的消费需求量上涨。
边缘蚀刻应在铜金属化之前的前道、铜金属化之后的后道进行。我们的单晶圆边缘蚀刻系统巧妙结合了边缘和背面清洗工艺,从而取得了卓越成效。该系统的一大亮点在于,能让系统在清洗前自动对准真空吸盘上的晶圆,而其他系统通常需要手动对准。一旦对准中心,系统会对晶圆进行边缘清洗,而腔体中的传感器会始终确保晶圆保持中心位置。下一步需要翻转晶圆,以清洗晶圆背面。在晶圆旋转过程中,我们的设备会进行非接触式晶圆清洗。
我们的边缘蚀刻产品采用湿法工艺技术。该技术与干法工艺技术相比,具有更为明显的性能优势,还可大幅降低化学品消耗量。得益于我们的专有技术,该系统能更准确有效地对准晶圆中心,从而提供精确的边缘蚀刻,进而提高产品产能。我们的湿法蚀刻工艺可有效避免干法工艺的硅损害风险,同时还能提供1-7mm的可变晶圆边缘薄膜刻蚀/切割精度、+/-0.1mm的良好均匀性、可控的蚀刻选择性以及更低的化学品消耗,从而有效降低总体拥有成本。
·市场驱动因素
在主要市场中,工艺集成技术的复杂性和缺陷日益凸显,包括3D NAND闪存器件以及DRAM和先进的逻辑IC的生产制造。其部分原因在于更多层沉积膜层的叠加,和更大的晶圆中心到晶圆边缘的膜厚不均匀度。。这些先进设备对晶圆对准精度及效率要求很高,并且需要在边缘蚀刻和清洗工艺中高度精确地去除任何微粒以及其他任何潜在的破坏性材料残留物。3D NAND闪存市场预计将大幅增长。美国联合市场研究机构(Allied Market Research)的数据显示,到2030年,全球3D NAND闪存市场预计将达到782亿美元,这意味着2021年至2030年间的年复合增长率将达20.3%。这一增长的关键驱动因素包括:3D NAND设备的性能提升且延迟降低,以及各类数据中心(闪存器件的主要消费群体)的消费需求量上涨。
·面临的挑战和盛美上海的应对方法
虽然斜面大多在薄膜沉积过程中产生,但沉积的薄膜在晶圆边缘的厚度并不均匀。另外,晶圆本身的形状略呈椭圆,这给边缘蚀刻工艺带来了挑战。以往,制造商会采用干法边缘蚀刻工艺来去除边缘薄膜和污染物。然而,这种工艺会产生电弧,还有可能造成硅损伤。此外,如果晶圆不在中心位置,则难以精确清洗和蚀刻边缘,从而可能导致颗粒残留,进而影响设备产能。边缘蚀刻应在铜金属化之前的前道、铜金属化之后的后道进行。我们的单晶圆边缘蚀刻系统巧妙结合了边缘和背面清洗工艺,从而取得了卓越成效。该系统的一大亮点在于,能让系统在清洗前自动对准真空吸盘上的晶圆,而其他系统通常需要手动对准。一旦对准中心,系统会对晶圆进行边缘清洗,而腔体中的传感器会始终确保晶圆保持中心位置。下一步需要翻转晶圆,以清洗晶圆背面。在晶圆旋转过程中,我们的设备会进行非接触式晶圆清洗。
我们的边缘蚀刻产品采用湿法工艺技术。该技术与干法工艺技术相比,具有更为明显的性能优势,还可大幅降低化学品消耗量。得益于我们的专有技术,该系统能更准确有效地对准晶圆中心,从而提供精确的边缘蚀刻,进而提高产品产能。我们的湿法蚀刻工艺可有效避免干法工艺的硅损害风险,同时还能提供1-7mm的可变晶圆边缘薄膜刻蚀/切割精度、+/-0.1mm的良好均匀性、可控的蚀刻选择性以及更低的化学品消耗,从而有效降低总体拥有成本。
·预期结果
盛美上海边缘蚀刻产品已安装于各大客户现场,此次安装的相关数据彰显了该技术的强大优势。边缘SC1和DHF蚀刻分别使用氮化钛和氧化硅薄膜在晶圆上进行1mm的测试。在切割宽度较窄的情况下,该工艺具有出色的均匀性 — TiN和ThOX的均匀性分别为2.22%和3.16%。当前,先进存储及逻辑器件产能持续提升,我们的边缘蚀刻系统销售量也在不断增长,我们期待业绩能趁此势头,继续保持强劲的增长态势。








